半導體器件中的鍵合工藝材料主要采用Au、Al、Cu及Ag四種金屬作為引線(xiàn),從而實(shí)現芯片與引出端的電氣互聯(lián)。在軍工、宇航等高可靠性半導體器件中的引線(xiàn)材料主要是以Au及Al為主,Cu及Ag作為鍵合材料在半導器件封裝中同樣應用廣泛。Au線(xiàn),廣泛引用熱壓鍵合及熱超聲鍵合工藝中,適用于各類(lèi)半導體器件芯片的互聯(lián)要求,是目前應用最廣的鍵合材料。
鍵合引線(xiàn)的力學(xué)性能評價(jià)方法
鍵合引線(xiàn)的電性能、熱性能的評價(jià)主要取決于鍵合引線(xiàn)的材料,而力學(xué)性能的評價(jià)可以按JESD22-B116A-2009(引線(xiàn)鍵合剪切試驗方法)及MIL-STD-883K方法2011.9(鍵合拉力)進(jìn)行。其中JESD22-B116A-2009覆蓋了直徑(18μm~76μm或0.7mil~3mil)制成的球形鍵合和用直徑較大(至少3mil)制成的楔形鍵,此類(lèi)鍵合常用于集成電路和混合微電子組件。該方法屬于破壞性試驗,用于工藝控制和質(zhì)量保證,適用于當球高度至少10.16μm或0.4mil的球形鍵合或鍵合高度至少1.25mils焊接區域的楔形鍵合。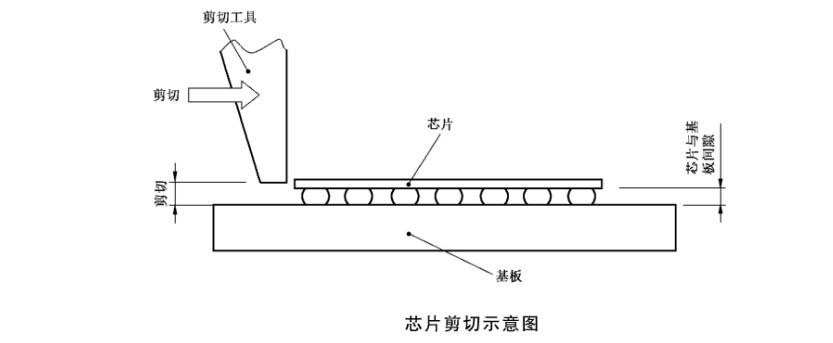
鍵合剪切就是利用推刀去剪切鍵合點(diǎn),使其與鍵合焊盤(pán)分離的過(guò)程。分離時(shí)所需的力稱(chēng)作鍵合剪切力。球形鍵合的鍵合點(diǎn)剪切分離模式共有6種類(lèi)型,其中類(lèi)型4及類(lèi)型5屬于無(wú)效模式,應將這些數據剔除外。
1.鍵合點(diǎn)分離
2.鍵合點(diǎn)切斷
3.凹坑
4.鍵合工具與鍵合面接觸
5.跳剪
6.鍵合焊盤(pán)部分分離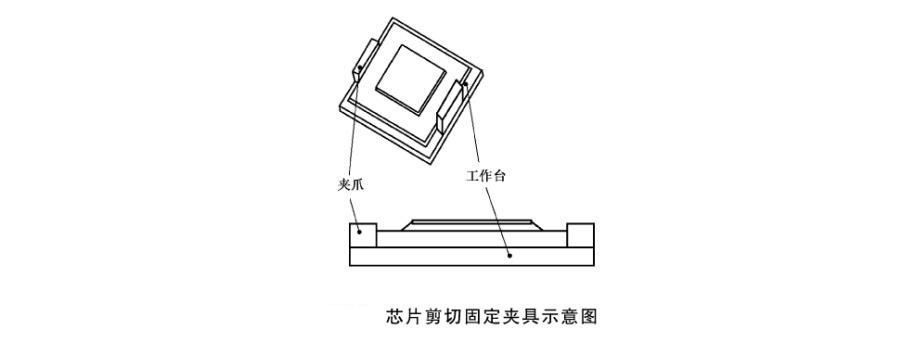
鍵合剪切試驗之前應對焊盤(pán)鍵合進(jìn)行檢查,尤其是塑封集成電路,因為采用濕式化學(xué)或干法刻蝕開(kāi)封后,鍵合表面的金屬化合物因蝕刻而缺失或存在顯著(zhù)的化學(xué)腐蝕現象,所以在鍵合焊盤(pán)上,有顯著(zhù)化學(xué)腐蝕或無(wú)金屬化區的鍵合點(diǎn),不應進(jìn)行剪切試驗。然后對所試的球形鍵合點(diǎn)的直徑進(jìn)行測量,因為球鍵合的鍵合剪切力與球鍵合的直徑有關(guān),而且鍵合剪切力是鍵合點(diǎn)和鍵合面金屬化層之間金屬鍵合的一個(gè)質(zhì)量指標。
測試設備應使用校準的負載單元或傳感器;鍵合剪切力測試儀的最大負載能力應足以把芯片從固定位置上分離或大于規定的最小剪切力的 2 倍。設備準確度應達到滿(mǎn)刻度的5%。設備應能提供并記錄施加于芯片的剪切力,也應能對負載提供規定的移動(dòng)速率。


